Электронно-лучевая литография
Общие положения
Размеры элементов в фотолитографическом процессе принципиально ограничены длиной волны используемого излучения. Для дальнейшего уменьшения элементов ИС необходимо применение электронно-лучевой и рентгеновской литографии.
Применение электронно-лучевой литографии позволяет:
а) получать элементы рисунка с размерами менее или равными 0,01 мкм (для фотолитографии не менее 0,5 мкм);
б) с высокой точностью контролировать дозу электронного пучка, падающего на резист и подложку;
в) легко отклонять и модулировать электронный пучок с высокой точностью электрическими и магнитными полями;
г) формировать в ряде случаев топологию схемы непосредственно на пластине;
д) автоматизировать технологию создания топологического рисунка;
е) профилировать электронный пучок.
Существенным недостатком электронно-лучевой литографии является ее малая производительность по сравнению с оптической.
Создание субмикронной топологии требует фокусировки электронного луча в пятно диаметром около 0,01 мкм. При таких линейных размерах элементов топологии сканирование и прерывание электронного луча можно проводить только при использовании ЭВМ. Система управления при этом работает на частотах в несколько мегагерц.
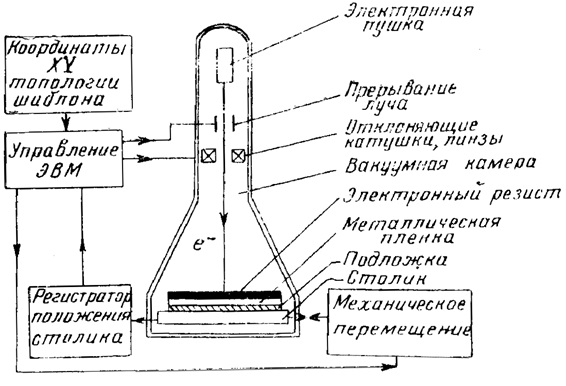
Рис. 1. Принципиальная схема электронно-лучевой литографической установки
Уменьшение диаметра электронного пучка до указанных размеров требует использования термоэлектронных пушек с плотностью тока более 104 А/м2 и электронно-оптических немагнитных линз. Угловое сканирование электронного луча при этом ограничивается, т. е. ограничивается площадь, которую можно обработать, не меняя позицию пластины до величины порядка 10 мм. Пластина при электронно-лучевой литографии помещается обычно под электронным лучом на координатном столике (рис. 1). Для совмещения с топологическим рисунком предыдущего уровня обычно используются знаки совмещения, вытравленные предварительно в подложке. Положение этих знаков определяется по вторичным и обратно рассеянным электронам.
Электронные резисты, взаимодействие электронов с резистом и материалом подложки
К резистам, применяемым в электронно-лучевой литографии, предъявляются такие же требования, как к фоторезистам в фотолитографии. В электронных резистах обычно происходят процессы расщепления цепочки в молекулах полимера под действием ионизирующего излучения (электронного пучка). При этом происходит уменьшение молекулярного веса полимера и он становится растворимым в специальном растворителе, не действующем на высокомолекулярный материал. Такие полимеры называются позитивными электронными резистами. В негативных электронных резистах под действием облучения электронами происходят процессы образования поперечных связей в молекулах полимера и формирования сложной трехмерной структуры. Необлученные участки полимера при этом имеют значительно меньший молекулярный вес по сравнению с облученными и удаляются путем растворения. При проникновении электронного луча В резист и подложку происходит взаимодействие электронов с веществом, их упругое и неупругое рассеяние (рис. 2).

Рис. 2. Основные виды взаимодействия электронов с веществом
Таким образом, доза экспонирования одного участка пластины воздействует на процесс экспонирования соседних областей, что приводит к размытию профиля распределения энергии экспонирования. Это явление в электронно-лучевой литографии получило название эффекта близости.
Технологические операции процесса электронно-лучевой литографии
Формирование элементов топологии заданных размеров, как правило, требует нескольких перемещений электронного луча, при этом промежутки между двумя соседними положениями луча равны половине ширины луча. Луч в электроннолучевой литографии имеет обычно гауссово распределение интенсивности. Различают два основных метода формирования электронным лучом топологии ИС — векторное и растровое сканирование.
При векторном сканировании луч направляется в заданное по программе место на схеме, он включается и выключается. После окончания сканирования одного участка пластины происходит перемещение координатного столика в плоскости XY так, чтобы в поле действия электронного луча попал следующий участок. В системе векторного сканирования необходимо использование сложной электронной оптики, позволяющей с субмикронной точностью осуществлять перемещение электронного пучка.
Растровое сканирование, наоборот, требует прецизионного перемещения координатного столика, поскольку в этом методе электронный луч непрерывно сканирует по полю малого размера (обычно несколько десятков микрон).
Векторная сканирующая система позволяет формировать топологию ИС при помощи электронного луча изменяемой формы. Электронному лучу, проходящему через апертуру, придается определенная форма. Вторая апертура, встречающаяся на пути луча, формирует электронный пучок определенной геометрической формы в плоскости его сечения. Этот способ позволяет значительно увеличить производительность метода электронно-лучевой литографии и довести время формирования изображения на пластине диаметром 125 мкм до нескольких минут, т. е. увеличить его на порядок. Повышение производительности может быть достигнуто с помощью одновременной обработки пластин несколькими электронными лучами.
Рентгеновская литография
Рентгеновская литография является по существу частным случаем оптической бесконтактной печати с длиной волны экспонирующего облучения в пределах 0,4—5 мм и величиной зазора между шаблоном и пластиной порядка 40 мкм. Проявление дифракционных эффектов в этом методе за счет малой
Величины длины волны рентгеновского излучения сведено до минимума.
Применение метода рентгеновской литографии позволяет:
а) одновременно получать высокое разрешение элементов топологии и высокую производительность процесса переноса изображения;
б) уменьшить проявление эффектов рассеяния в резистах и подложке за счет малой величины энергии мягкого рентгеновского излучения.

Рис. 3. Геометрические искажения в рентгенографии
К недостатку метода следует отнести так называемый геометрический эффект (рис. 3). Конечная протяженность источника рентгеновского излучения d приводит к размытию изображения на резисте δ = d(g/L). Размытие изображения элементов топологии обычных установок рентгеновской литографии достигает величины порядка 0,2 мкм.